Твердотельная электроника. Учебное пособие.
6.13. МНОП-транзистор
Величина порогового напряжения VT определяется уравнением (6.64). Как видно из этого уравнения, для изменения величины порогового напряжения VT необходимо:
а) изменить легирование подложки NA (для изменения объемного положения уровня Ферми φ0, разности paбот выхода φms, заряда акцепторов в области обеднения QВ);
б) изменить плотность поверхностных состояний Nss;
в) изменить встроенный в диэлектрик заряд Qох;
г) изменить напряжение смещения канал подложка VSS (для изменения заряда акцепторов QВ в слое обеднения). Поскольку информацию в ячейку необходимо перезаписывать многократно, случаи а) и б) для этого оказываются непригодными. Случай г) не подходит вследствие того, что при отключении напряжения информация не сохраняется. Таким образом, для реализации энергонезависимого репрограммируемого полупроводникового запоминающего устройства (РПЗУ) необходим МДП-транзистор, в котором обратимым образом было бы возможно изменять пороговое напряжение VT за счет изменения встроенного в диэлектрик заряда Qох.
Наиболее распространенными РПЗУ, в которых реализован этот принцип, являются РПЗУ на основе полевых транзисторов со структурой металл - нитрид - окисел - полупроводник (МНОП транзисторы) и на основе полевых транзисторов с плавающим затвором.
На рисунке 6.16а, б приведена схема, показывающая основные конструктивные элементы МНОП ПТ и МОП ПТ с плавающим затвором.
В МНОП ПТ в качестве подзатворного диэлектрика используется двухслойное покрытие. В качестве первого диэлектрика используется туннельно прозрачный слой (dox < 50 A) двуокиси кремния. В качестве второго диэлектрика используется толстый (d ≈ 1000 A) слой нитрида кремния. Нитрид кремния Si3N4 имеет глубокие ловушки в запрещенной зоне и значение диэлектрической постоянной εSi3N4 в два раза более высокое, чем диэлектрическая постоянная двуокиси кремния SiO2. Ширина запрещенной зоны нитрида Si3N4 меньше, чем ширина запрещенной зоны окисла SiO2.
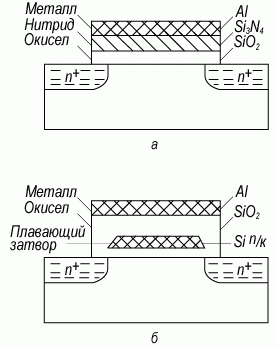
Рис. 6.16. Топология полупроводниковых запоминающих устройств:
а) МНОП-транзистор; б) МОП ПТ с плавающим затвором
На рисунке 6.17а приведена зонная диаграмма МНОП-транзистора. Рассмотрим основные физические процессы, протекающие в МНОП-транзисторе при работе в режиме запоминающего устройства. При подаче импульса положительного напряжения +VGS на затвор вследствие разницы в величинах диэлектрических постоянных окисла и нитрида в окисле возникает сильное электрическое поле. Это поле вызывает, как показано на рисунке 6.17б, туннельную инжекцию электронов из полупроводника через окисел в нитрид. Инжектированные электроны захватываются на глубине уровня ловушек в запрещенной зоне нитрида кремния, обуславливая отрицательный по знаку встроенный в диэлектрик заряд. После снятия напряжения с затвора инжектированный заряд длительное время хранится на ловушечных центрах, что соответствует существованию встроенного инверсионного канала. При подаче импульса отрицательного напряжения -VGS на затвор происходит туннелирование электронов с ловушек в нитриде кремния в зону проводимости полупроводника, как показано на рисунке 6.17в. При снятии напряжения с затвора зонная диаграмма МНОП-структуры снова имеет вид, как на рисунке 6.17а, и инверсионный канал исчезает.
Оценим величину инжектированного заряда, необходимую для переключения МНОП-транзистора. Пусть величина ΔVT = 10 В, dSi3N4 = 1000 A, εSi3N4 = 6.
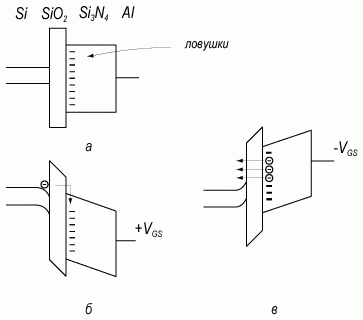
Рис. 6.17. Зонная диаграмма МНОП-транзистора:
а) напряжение на затворе равно нулю, ловушки не заполнены; б) запись информационного заряда; в) стирание информационного заряда
 (6.84)
(6.84)Подставив численные значения в (6.84), получаем ΔNox ≈ 3·1011 см-2. Считая, что захват идет в энергетический интервал 1 эВ в запрещенной зоне нитрида и в слой толщиной 100 A, получаем, что энергетическая плотность объемных ловушек Nt в нитриде должна быть порядка 2·1018 см-3·эВ-1.
Copyright © 2003-2008 Авторы


 Полевые транзисторы - МНОП-транзистор
Полевые транзисторы - МНОП-транзистор