|
А. Строгонов Долговечность интегральных схем и производственные методы ее прогнозированияОбщие проблемы, связанные с прогнозированием долговечности ИС по результатам ускоренных испытаний Зависимость интенсивности отказов от времени работы ИС имеет вид кривой (называемой иногда "ванной", рис. 1), которая характеризуется тремя периодами: периодом приработки (называемого иногда периодом "детских" или ранних отказов), в котором интенсивность отказов вначале велика, а затем быстро падает; периодом нормальной работы, то есть основной, в котором значение интенсивности отказов постоянно, и периодом старения (примерно через 25-30 лет нормальной работы), в котором интенсивность отказов начинает вначале медленно, а затем более быстро возрастать. Однако, данная стадия у ИС только предполагается. Рисунок 1. Типовая зависимость интенсивности отказов ИС от времени: 1 - без отбраковочных испытаний; 2 - с проведением отбраковочных испытаний
Ранние отказы возникают, как правило, вследствие конструктивных и технологических недостатков. В нормальных условиях работы этот период длится до 1000 ч. или примерно 6 недель. На окончание этого этапа указывает выравнивание кривой интенсивности отказов. Интенсивность отказов в период приработки имеет тенденцию к уменьшению по мере усовершенствования конструкции и технологии. Для периода нормальной работы в отечественной практике установлено, что интенсивность отказов В зарубежной практике за основной показатель над╦жности применяется среднее время наработки на отказ: MTTF = 109/ФИТ, где ФИТ = За базовую модель зависимости интенсивности отказов от температуры принимается уравнение Аррениуса. В 1889 году Сванте Аррениус вывел это уравнение эмпирически, изучая влияние температур на скорость превращения сахарозы, за что был удостоен Нобелевской премии в области химии. Это уравнение приближенно описывает многие деградационные процессы и отказы ИС, в том числе ионный дрейф, диффузию примесей, образование интерметаллических соединений, ползучесть, кристаллографические микроперестроения конструкционных материалов. Уравнение Аррениуса в равной степени хорошо описывает появление отказов ИС при воздействии повышенной температуры, как в период приработки, так и в период старения. Практика эксплуатации и опыт ускоренных испытаний показали, что распределение долговечности в зависимости от температуры описывается лог-нормальным распределением с возрастающей функцией интенсивности отказов. Лог-нормальное распределение также хорошо описывает отказы, когда нагрузкой выступает повышенная влажность и повышенная напряж╦нность электрического поля в оксиде. В общем случае, для многих полупроводниковых приборов и ИС, долговечность которых подчиняется закону Аррениуса, справедливы следующие обобщения:
Опыт ускоренных испытаний ИС на долговечность показывает, что интенсивность отказов имеет бимодальный характер - отказы аномальных ИС ("больные ИС"), то есть ИС имеющих скрытые дефекты, и отказы основной части выборки ("здоровые ИС"). Рис. 2 показывает, что ИС, содержащие скрытые дефекты, не позволяют получить интенсивность отказов менее 100 ФИТ, характерную для основной части выборки. Рисунок 2. Интенсивность отказов ИС фирмы Intel по годам выпуска: 1 - основная часть выборки ("здоровые"); 2 - аномальные ИС ("больные")
Определение долговечности ИС в производственной практике В настоящее время для определения времени наступления периода старения ИС, то есть их долговечности, оста╦тся практически единственный способ ≈ проведение ускоренных испытаний, при которых ИС работают в условиях более высоких нагрузок, чем при нормальной эксплуатации. Результаты, полученные при повышенных нагрузках, экстраполируют на нормальные условия эксплуатации. Цель ускоренных испытаний ИС на долговечность заключается в том, чтобы старение ускорилось, а процесс деградации параметров происходил так же, как и при нормальной работе схемы. В качествекачестве меры, показывающей, как сокращается долговечность за сч╦т развития дефектов при повышении температуры от T1 к T2, служит коэффициент ускорения KyT:
где верхний индекс T подчеркивает влияние температуры; t1 и t2 - среднее время наработки на отказ при температурах T1 и T2, соответственно; T11 и T2 - соответственно нормальная и повышенная температуры; Ea - энергия активации для наблюдаемого процесса старения; P1 и P2 - рассеиваемые мощности на переходе; q1 и q2 - термические коэффициенты сопротивления (ТКС) зоны переход√окружающая среда. Относительно небольшое изменение энергии активации процесса старения вызывает весьма существенное изменение коэффициента ускорения. KyT показывает экспоненциальную зависимость от температуры в диапазоне 0,3√1,3 эВ. Обычно фактор ускорения при температуре 55°С принимается равным единице. При этом получаемые факторы ускорения при 125╟С по отношению к окружающей температуре 55°С изменяются от 1 до 104, в зависимости от изменения энергии активации. Установлено, что чем меньше получаемая экспериментально энергия активации, тем незначительнее температурная зависимость процесса старения. Например, при повышении температуры испытаний с T0 = 40°С до T1 = 70°С происходит смена доминирования типов отказов. В режиме применения ИС доминировал процесс с энергией активации Ea = 0,3 эВ, на долю которого приходилось 62% отказов. В форсированном режиме доминирующим оказался процесс с Ea = 1,0 эВ, дающий 70% отказов. Если принять, что различные дефекты влияют приблизительно одинаково на изменение интенсивности отказов, то можно считать, что средняя энергия активации равна 0,4 эВ. В соответствии с правилом "10 градусов", принимают, что скорость старения увеличивается вдвое при увеличении температуры на 10°С. Этому закону нарастания скорости старения соответствует энергия активации в пределах 0,7/0,8 эВ. Именно эту величину 0,7 эВ фирма Analog Devices использует в расч╦тах интенсивности отказов. Фирма Micro-chip в расч╦ты закладывает величину 0,6√0,7 эВ. Экспериментальные исследования показали, что на практике для многих типов ИС не наблюдается корреляционная связь между интенсивностью отказов и температурой p-n-перехода (рис. 3), то есть нет экспоненциальной зависимости числа отказов от температуры. В правильно сконструированном радиоэлектронном изделии температурные эффекты могут быть скомпенсированы, так что в диапазонах умеренных температур этот фактор можно исключить. Рисунок 3. Поле корреляции между температурой p-n-перехода и интенсивностью отказов биполярных логических ИС
На рис. 4 показано, как происходит рассеяние срока службы ИС при экстраполяции результатов ускоренных испытаний при температурах 70, 100, 125°С к температуре 40°С и при допущении, что кривая интенсивности отказов описывается лог-нормальным распределением. Видно, что какая-то часть ИС при таких температурах откажет значительно раньше, чем за 100 лет, а другая часть ИС будет иметь срок службы значительно больший, чем 100 лет, вплоть до нескольких тысяч лет. Рисунок 4. Рассеяние срока службы ИС при экстраполяции результатов ускоренных испытаний при температурах 70, 100, 125°С к температуре 40°С и при допущении, что кривая интенсивности отказов описывается лог-нормальным распределением
В производственной практике долговечность ИС определяют по результатам статической или динамической электротермотренировки (ЭТТ), позволяющей выявлять отказы ИС с разной энергией активации. Наибольшее распространение получили два варианта, а именно:
К первому варианту испытаний можно отнести все виды электротермотренировок. Тренировка фактически ускоряет старение ИС и предназначена для "выжигания" ранних отказов и повышения над╦жности партии оставшихся в ней ИС. Специалисты фирмы Analog Devices считают, что 1000 ч. испытаний при 125°С эквивалентно 10 годам при температуре 55°С. Многие специалисты считают, что испытания при температурах 125°С в течение 1000 ч. дают обычно только информацию о доле забракованных ИС в партии. Некоторые виды тренировок способны инициировать износовые отказы. В показано, что динамическая ЭТТ пригодна для прогнозирования долговечности большинства ИС, связанной с износовыми отказами, с низкой энергией активации (порядка 0,3√0,4 эВ), в том числе для БИС и СБИС. Испытания, проводимые при температурах, физически допустимых конструкцией ИС (200√300°С), будут инициировать отказы, связанные с высокой энергией активации. Высокотемпературное старение способно выявить в течение нескольких часов такие изменения в элементах конструкции схем, которые в конечном сч╦те произошли бы в них при длительной работе (может быть, в течение нескольких десятков лет) в нормальных условиях. При высоких температурах, близких к пороговым, можно наблюдать механизмы отказов, относительно редко проявляющиеся при умеренных температурах. При таких температурах "здоровые" ИC начинают выходить из строя уже через 48√100 часов испытаний. Некоторые фирмы изготовители ИС используют испытания на времязависимый пробой диэлектрика, который проявляется в период старения ИС. Для рабочих полей порядка нескольких мегавольт на сантиметр (3√8 МВ/см) был эмпирически получен коэффициент ускорения срока службы диэлектрика в результате воздействия электрического поля, равный 107/МВ/см. Заставляя работать ИС в течение небольшого промежутка времени (кратковременное функционирование при полях около 8 МВ/см) при повышенном напряжении питания, можно инициировать усталостную нагрузку, что может быть более эффективным способом отбраковки ИС с дефектным оксидом, чем их термотренировка при номинальном напряжении. Первый вид испытаний регламентируется зарубежными справочниками типа MIL-HDBK-217 (военный американский справочник по предсказанию над╦жности электронного оборудования), используемыми ведущими фирмами-изготовителями ИС, такими как Atmel, ADI, Siemens, Microchip и другие. Условия и режимы проведения ЭТТ для определения долговечности зарубежные фирмы устанавливают самостоятельно, однако в большинстве случаев они схожи с условиями и режимами, указанными в MIL-HDBK-217. В расч╦ты закладывают два коэффициента ускорения: один, вызванный температурой KyT, второй ≈ напряжением KyU. В отечественных отраслевых методах расч╦тно-экспериментального прогнозирования над╦жности рекомендуется использовать коэффициент ускорения Ky для различных механизмов отказа. В справочнике MIL-HDBK-217 при расч╦тах над╦жности количественное значение уровня ранних отказов моделируется с помощью коэффициента ПQ, а прогнозирование долговечности, в зависимости от изменения температуры, осуществляется варьированием коэффициента ПT, базирующегося на уравнении Аррениуса, исходя из уравнения :
где ПQ - коэффициент, зависящий от подготовки и качества процесса производства; С1 и С2 - коэффициенты сложности элемента; ПT - коэффициент, зависящий от температуры кристалла и технологии; ПV - коэффициент, зависящий от нагрузки по напряжению для КМОП-схем; ПPT - коэффициент, учитывающий способ программирования памятей типа ОЗУ, ПЗУ; ПL - коэффициент, зависящий от отработанности технологического процесса. Экспериментальную интенсивность отказов ведущие фирмы-изготовители (например, Siemens AG, Analog Devices (ADI), Atmel, Xilinx) рекомендуют оценивать по результатам ЭТТ (предпочтительно, динамической) по формуле:
где x² ≈ распределение; P ≈ доверительная вероятность (0,5√0,95), связанная с уровнем значимости CL соотношением 1 - CL/100; v = (2n +2), где n - количество отказавших ИС; N - общее число испытуемых ИС; Расч╦тные значения интенсивности отказов и среднего времени наработки на отказ, для случая, когда за время испытаний отказов не зарегистрировано, с использованием статистики х², приведены в табл. 2. В табл. 3 показаны результаты испытаний БИКМОП ИС фирмы ADI с 0,3√4 мкм проектными нормами. В табл. 4 приведены результаты испытаний полупроводниковой продукции фирмы Microchip за 1998 год, с 60-% уровнем значимости по методике HTOL. Температура испытаний выбирается равной 125°С. Экстраполируемая температура - 55°С. Получаемый коэффициент ускорения - 78 при энергии активации 0,7 эВ и 42 при энергии активации 0,6 эВ. Таблица 1.Некоторые результаты испытаний КМОП ИС фирмы ADI
В таблице могут быть мелкие неточности, поэтому рекомендуем обратиться к файлу в формате .pdf Таблица 2.Некоторые результаты испытаний КМОП ИС фирмы ADI
В таблице могут быть мелкие неточности, поэтому рекомендуем обратиться к файлу в формате .pdf Таблица 3.Некоторые результаты испытаний БИКМОП ИС фирмы ADI с 0,3√4 мкм проектными нормами
Таблица 4.НРезультаты испытаний полупроводниковой продукции фирмы Microchip за 1998 финансовый год, с 60-% уровнем значимости (методика HTOL)
В таблице могут быть мелкие неточности, поэтому рекомендуем обратиться к файлу в формате .pdf Фирма Atmel приводит следующий пример расч╦та интенсивности отказов по методике HTOL: 125°С, 1000 ч. (1 отказ, размер выборки 500 ИС) при 60-% уровне значимости: 
KyU = exp(1,0[6,5 √ 5,0]) = 4,5, Ky = KyT·KyU = 21,3·4,5 = 95,9,
На рис. 5 приведены интенсивности отказов программируемых пользователем вентильных матриц (ППВМ), выполненных по технологии статических оперативных запоминающих устройств (СОЗУ) компании Xilinx - мирового лидера в производстве перепрограммируемых логических схем. Интенсивности отказов получены по результатам ускоренных испытаний (статическая и динамическая ЭТТ при температуре 125°С) свыше 20000 приборов в течение двух лет, при этом общая наработка на отказ составила 36 млн. приборо-часов. Рисунок 5. Интенсивность отказов ППВМ компании Xilinx семейства XC2000, XC3000, XC4000
В табл. 5 приведены формулы для вычисления коэффициентов ускорения по разным регламентирующим документам (РД) и литературным данным, когда ускоряющим фактором выступает температура или напряжение, или их комбинация. В каждом документе обозначены свои правила определения констант и температур переходов. Документ NTT procedure предусматривает один коэффициент ускорения для всех ИС, американский справочник MIL-HDBK 217 - 25 для разных технологий изготовления ИС, разделенных на 7 категорий. Документ CNET предусматривает разные коэффициенты ускорения для четыр╦х типов технологий и зада╦т две разные константы для герметичных и негерметичных изделий. Процедура фирмы Siemens использует одни и те же константы для всех ИС, за исключением перепрограммируемых интегральных запоминающих устройств. Вс╦ это приводит к тому, что температурные коэффициенты ускорения, вычисленные по разным методикам для одной и той же ИС, существенно отличаются. Таблица 5.Основные модели коэффициента ускорения при действии различных механизмов отказа
Примечания: В таблице могут быть мелкие неточности, поэтому рекомендуем обратиться к файлу в формате .pdf Расч╦ты показывают, что значения коэффициентов ускорения для одной и той же ИС, работающей в одних и тех же условиях, в одинаковых корпусах (герметичном или не герметичном), уже при температурах порядка 100°С могут различаться более чем в 100 раз, в зависимости от того, по какому документу их рассчитывают. Эта разница увеличивается при повышении температуры. Весьма существенны и различия в интенсивностях отказов одной и той же ИС при разных температурах, определ╦нные по разным документам. Для температуры 20°С для негерметичных корпусов они отличаются от 8 до 790 ФИТ, а для температуры 80°С - от 33 до 5648 ФИТ, то есть больше, чем на два порядка. В табл. 6 приведены математические модели для вычисления времени до отказа tF элементов конструкции ИС, полученные по результатам ускоренных испытаний. Обобщая результаты ускоренных испытаний ИС на долговечность, можно сделать следующие выводы:
Список используемой литературы можно получить у автора статьи (andreis@hotmail.ru). |
||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||


 Долговечность интегральных схем и производственные методы ее прогнозирования.
Долговечность интегральных схем и производственные методы ее прогнозирования.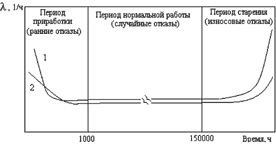
.gif)